前言
在半导体制造工序中,工艺精度的提升与封装密度的增加,对视觉检测提出了更高要求——既要实现高精度检测,又需兼顾复杂材质与高速生产环境。埃科光电SG系列3D线光谱共焦传感器,以亚微米级精度、高速在线检测与无接触成像能力,攻克微小缺陷识别及复杂表面适配等难题,直击半导体制造核心检测场景,为芯片质量保驾护航。

晶圆表面缺陷检测
晶圆表面缺陷包括颗粒、裂纹、凹坑和脏污等,这些缺陷会直接影响产品质量及生产效率。
检测难点
有图晶圆表面特征复杂,且缺陷类型多样,容易造成误判和漏判。
应用效果
埃科SG系列线光谱共焦传感器横向分辨率高,能够捕捉到晶圆细微特征及缺陷;最高扫描速率达到30kHz,满足半导体行业高速在线检测节拍。
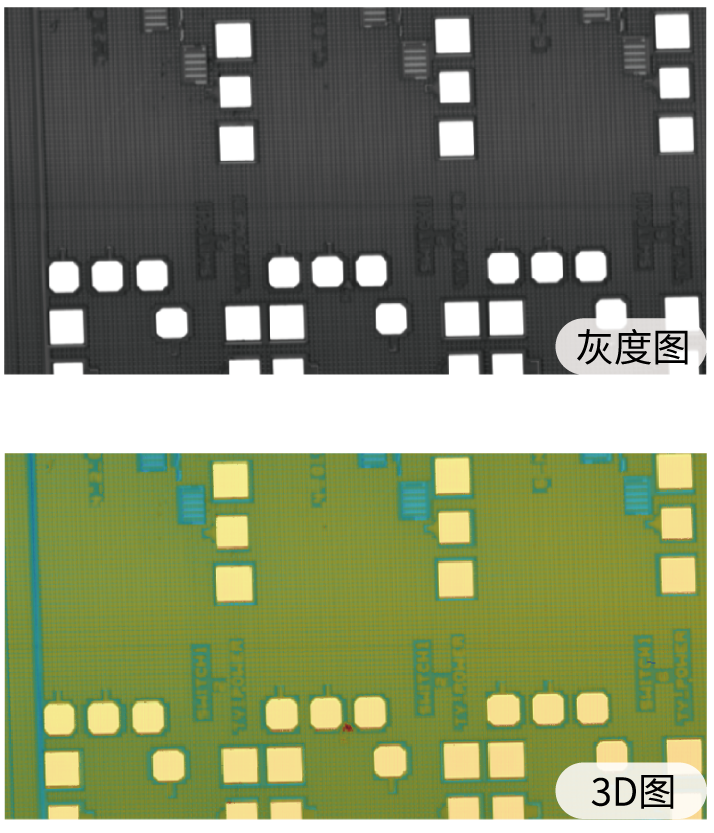
晶圆BGA锡球检测
BGA(球栅阵列)封装是一种密度高、散热性能强且应用广泛的芯片封装方式。
检测难点
(1)锡球尺寸小,通常直径只有几十微米,识别球面瑕疵须达到微米级别精度。
(2)锡球表面金属反光会干扰光学检测,且密集排列的锡球易产生遮挡,影响缺陷定位。
应用效果
SG1007基于同轴式光谱共聚焦技术开发而成,最大镜面兼容角度±50°,X方向分辨率1.9µm,轴向重复性精度达50nm,可实现球高、球径无遮挡高精度测量,全量程范围内扫描速率可达到8.9kHz,一定测量范围内可实现30kHz高速扫描,高效应对BGA锡球检测。

晶圆金线检测
在半导体后道封装工序中,引线键合通过微米级金属导线(通常为金线、铜线等)实现芯片内外部的电气互连。
检测难点
(1)随着半导体工艺的发展,金线间距、线径均为数十微米,塌线、断线等缺陷需要微米级的高分辨率成像实现捕捉。
(2)金线表面存在高反光干扰,且键合后焊盘表面可能存在残胶等异物,传统光学传感器对这类材质难以准确成像。
应用效果
SG4025凭借X方向2.5µm的高分辨率,实现对高密度细微金线精确成像;2.5mm的测量范围可检测金线高度;同时,线光谱共焦技术无惧金线表面高反光影响,具有强材质适应性,解决了传统成像难点。
产品参数

结语
埃科SG系列线光谱共焦传感器不受材质、形状和反光的影响,对于深孔、缝隙、弯曲、透明等多种形貌或材质的表面测量有着高度的适应性,全量程都可保持高精度及高横向分辨率,助力半导体、消费电子、PCB等多个精密制造行业实现更高效、准确的自动检测。
转自:埃科光电
注:文章版权归原作者所有,本文内容、图片、视频来自网络,仅供交流学习之用,如涉及版权等问题,请您告知,我们将及时处理。



















